倒焊芯片是裸芯片封装技术之一,在LSI 芯片的电极区制作好金属凸点,然后把金属凸 点 与印刷基板上的电极区进行压焊连接。封装的占有面积基本上与芯片尺寸相同。是所有 封装技 术中体积最小、最薄的一种。 但如果基板的热膨胀系数与LSI 芯片不同,就会在接合处产生反应,从而影响连接的可 靠 性。因此必须用树脂来加固LSI 芯片,并使用热膨胀系数基本相同的基板材料。
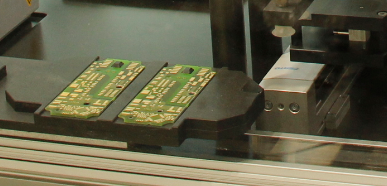
什么是倒焊芯片?
倒焊芯片是一种芯片互连技术,又是一种理想的芯片粘接技术.早在30年前IBM公司已研发使用了这项技术。但直到近几年来,倒焊芯片已成为高端器件及高密度封装领域中经常采用的封装形式。如今倒焊芯片封装技术的应用范围日益广泛,封装形式更趋多样化,对倒焊芯片封装技术的要求也随之提高。
倒焊芯片是一种较新的支持表明安装板的封装形式,采用C4可控塌陷芯片法焊接,大幅度改善电器性能,据称能提高封装成品率。这种封装允许直接连接到底层,具体来说由倒装在元件底部上的硅核组成,使用金属球代替原先的针脚来连接处理器,如果把焊接比喻成缝衣的话,那么这种焊接方式可以让针脚均匀一致,连接距离更短引脚间距增大,避免了虚焊和针脚弯曲弯曲现象。
倒焊芯片技术的优势
倒装焊芯片与正装芯片相比,它具有较好的散热功能;同时,我们有与倒装焊适应的外延设计、芯片工艺、芯片图形设计。芯片产品具有低电压、高亮度、高可靠性、高饱和电流密度等优点;再加上能在倒装焊的衬底上集成保护电路, 对芯片可靠性及性能有明显帮助;此外,与正装和垂直结构相比,使用倒装焊方式, 更易于实现超大功率芯片级模组、多种功能集成的芯片光源技术,在LED芯片模组良率及性能方面有较大的优势。
倒焊芯片封装杰出的热学性能是由低热阻的散热盘及结构决定的。芯片产生的热量通过散热球脚,内部及外部的热沉实现热量耗散。散热盘与芯片面的紧密接触得到低的结温。为减少散热盘与芯片间的热阻,在两者之间使用高导热胶体。使得封装内热量更容易耗散。为更进一步改进散热性能,外部热沉可直接安装在散热盘上,以获得封装低的结温。
倒焊芯片封装另一个重要优点是电学性能。引线键合工艺已成为高频及某些应用的瓶颈,使用Flip-Chip封装技术改进了电学性能。如今许多电子器件工作在高频,因此信号的完整性是一个重要因素。
芯片倒装技术是非常热门的一门技术,之所以未能普及,有很多原因。据业内人士表示,主要有两个原因,一是如何新技术都需要一段时间的摸索才会成型,最终由市场才决定他的生命;二是倒装LED颠覆了传统LED工艺,从芯片一直到封装,这样会对设备要求更高,就拿封装才说,能做倒装芯片的前端设备成本肯定会增加不少,这就设置了门槛,让一些企业根本无法接触到这个技术。








我的评论
最新评论